Difference between revisions of "Laser Etch Monitoring"
(→Monitoring Photoresist Etch Rate: updated captions) |
(→Specific Procedures: Added Oxford Laser Mon) |
||
| (2 intermediate revisions by the same user not shown) | |||
| Line 36: | Line 36: | ||
Procedures for specific machines are found on the following pages: |
Procedures for specific machines are found on the following pages: |
||
| − | *[[Intellemetrics Laser Etch Monitor Procedure for Panasonic ICP Etchers]] |
+ | *[[Intellemetrics Laser Etch Monitor Procedure for Panasonic ICP Etchers|Intellemetrics Laser Etch Monitor Procedure - Panasonic ICP Etchers]] |
**Installed on [[ICP Etch 1 (Panasonic E626I)|Panasonic ICP #1]] & [[ICP Etch 2 (Panasonic E640)|ICP #2]] |
**Installed on [[ICP Etch 1 (Panasonic E626I)|Panasonic ICP #1]] & [[ICP Etch 2 (Panasonic E640)|ICP #2]] |
||
| − | *[[Intellemetrics Laser Etch Monitor Procedure for Plasma-Therm Etchers]] |
+ | *[[Intellemetrics Laser Etch Monitor Procedure for Plasma-Therm Etchers|Intellemetrics Laser Etch Monitor Procedure - Plasma-Therm Etchers]] |
**Installed on [[DSEIII (PlasmaTherm/Deep Silicon Etcher)|Plasma-Therm DSE-iii]] and [[Fluorine ICP Etcher (PlasmaTherm/SLR Fluorine ICP)|Fluorine ICP Etcher]] |
**Installed on [[DSEIII (PlasmaTherm/Deep Silicon Etcher)|Plasma-Therm DSE-iii]] and [[Fluorine ICP Etcher (PlasmaTherm/SLR Fluorine ICP)|Fluorine ICP Etcher]] |
||
| + | *Intellemetrics Laser Etch Monitor - Installed on [[Oxford ICP Etcher (PlasmaPro 100 Cobra)|Oxford ICP Etcher]] |
||
| + | **''Very similar procedure as PlasmaTherm tools. This one is an invisible 980nm nIR laser, for III-V etching.'' |
||
*[[Horiba Laser Etch Monitor Procedure for Unaxis VLR]] |
*[[Horiba Laser Etch Monitor Procedure for Unaxis VLR]] |
||
*[[Custom Laser Etch Monitor Procedure for RIE|Custom Laser Etch Monitor Procedure for RIE#2]] |
*[[Custom Laser Etch Monitor Procedure for RIE|Custom Laser Etch Monitor Procedure for RIE#2]] |
||
*[[Laser Etch Monitor Procedure for RIE5|Laser Etch Monitor Procedure for RIE5]] |
*[[Laser Etch Monitor Procedure for RIE5|Laser Etch Monitor Procedure for RIE5]] |
||
| + | |||
| + | ===Video Training=== |
||
| + | You must authorized for use on the Laser Monitors. Please contact [[Demis D. John|Demis]] for training. |
||
| + | |||
| + | *[https://gauchocast.hosted.panopto.com/Panopto/Pages/Viewer.aspx?id=c0cec10a-3498-40a2-a7ca-acdb0068d89f '''Video Training for Intellemetrics LEP500 Laser Etch Monitors'''] |
||
| + | **Applies to Plasma-Therm Fluorine ICP (SLR) & DSE-iii, and Panasonic ICP#1 and ICP#2. |
||
==Examples== |
==Examples== |
||
| Line 48: | Line 56: | ||
===Monitoring Photoresist Etch Rate=== |
===Monitoring Photoresist Etch Rate=== |
||
Even if you don't use the laser monitor to determine when your etched material is removed, monitoring the photoresist mask alone is very helpful. For example, you can known exactly what time the photoresist is fully etched through during an etch (even if by accident), allowing you to stop the etch at that time, and still determine selectivity if desired. |
Even if you don't use the laser monitor to determine when your etched material is removed, monitoring the photoresist mask alone is very helpful. For example, you can known exactly what time the photoresist is fully etched through during an etch (even if by accident), allowing you to stop the etch at that time, and still determine selectivity if desired. |
||
| − | [[File:ARC etch + Cr etch - UV6 at 2krpm (900nm) survived v2 - screenshot.jpg|alt=example of photoresist monitor during etch.|none|thumb|900x900px|Monitoring photoresist during two sequential etches: (1) ARC Etch (short O2 etch) |
+ | [[File:ARC etch + Cr etch - UV6 at 2krpm (900nm) survived v2 - screenshot.jpg|alt=example of photoresist monitor during etch.|none|thumb|900x900px|Monitoring photoresist during two sequential etches: (1) ARC Etch (short O2 etch) from 100sec→120sec, and |
| + | (2) subsequent Chromium etch (Cl2/O2) from 180sec until the etch completed at 500 sec. |
||
| ⚫ | [[File:Annotated PR etch - Om1000 03 - ARC + Cl + PR etch v1.jpg|alt=annotated laser monitor plot of PR during a 3-step etch.|none|thumb|900x900px|Monitoring the photoresist during a 3-step etch. Etch (1) Etches the Anti-Reflection underlayer (BARC) with O2, |
||
| + | Plot shows that the photoresist survived - the sinusoid continued until the etch stopped, indicating that photoresist was still present and being etched.]] |
||
| ⚫ | |||
| + | (2) etches Chromium with Cl2/O2 gases, and |
||
| + | (3) intentionally etches the photoresist quickly with O2 to remove it fully. Manually Ended the step 30 sec after the plot showed the PR was fully removed, to account for any nonuniformity across the wafer.]] |
||
<br /> |
<br /> |
||
==References== |
==References== |
||
Revision as of 13:14, 3 September 2021
| ||||||||||||||||||||||
Overview
A number of our dry etching systems have Laser Etch monitors installed, for "endpoint detection". These systems allow you to end your etch at a known etch depth, or within a certain layer (with some caveats). This nearly eliminates the need to calibrate etch rates or to use timed etching only, which is especially important in our lab where etch rates can vary depending on the previous etches performed in the chamber.
Laser Etch monitoring works similarly to optical thin-film measurement via reflectivity spectra (eg. like our Filmetrics systems). However, instead of varying the optical wavelength and measuring a fixed thin-film, we measure a constant wavelength and a thin-film that is varying as it is etched. Thus, similar to the thin-film measurements, you can only measure a useful signal when the optical properties (reflection or interference) change during your etch.
For example, Etching from high-reflectivity Aluminum to Lower reflectivity Silicon will usually give you a clear drop showing that your Aluminum has been fully etched-through.
Etching films that are transparent at the laser monitor wavelength (670nm) produces a sinusoidal signal due to optical wave interference which gives you numerous possible stopping points to end the etch upon.
Procedures
General Procedure
The basic method for performing an etch with laser monitoring endpoint, is as follows:
- Simulate or estimate what the laser monitor trace will look like, decide when to stop the etch according to the laser monitor plot.
- Mount the sample such that the laser will be able to reach a region to monitor the etch - typically ~100-300µm wide area.
- Load sample into chamber - wafer transfer only, no etch.
- Align Laser onto area to monitor using co-axial microscope.
- Start laser power monitoring/logging.
- Start Etch (time set longer than expected etch time) - etch only, no wafer transfers.
- Closely observe laser monitor plot, comparing to known/simulated plot.
- Use "Next Step" or "End Step" when appropriate laser monitor trace is reached. Wait for process to complete any final steps.
- Transfer wafer out of chamber.
- Save laser monitor data, turn off laser & microscope illumination.
Specific Procedures
Procedures for specific machines are found on the following pages:
- Intellemetrics Laser Etch Monitor Procedure - Panasonic ICP Etchers
- Installed on Panasonic ICP #1 & ICP #2
- Intellemetrics Laser Etch Monitor Procedure - Plasma-Therm Etchers
- Installed on Plasma-Therm DSE-iii and Fluorine ICP Etcher
- Intellemetrics Laser Etch Monitor - Installed on Oxford ICP Etcher
- Very similar procedure as PlasmaTherm tools. This one is an invisible 980nm nIR laser, for III-V etching.
- Horiba Laser Etch Monitor Procedure for Unaxis VLR
- Custom Laser Etch Monitor Procedure for RIE#2
- Laser Etch Monitor Procedure for RIE5
Video Training
You must authorized for use on the Laser Monitors. Please contact Demis for training.
- Video Training for Intellemetrics LEP500 Laser Etch Monitors
- Applies to Plasma-Therm Fluorine ICP (SLR) & DSE-iii, and Panasonic ICP#1 and ICP#2.
Examples
Monitoring Photoresist Etch Rate
Even if you don't use the laser monitor to determine when your etched material is removed, monitoring the photoresist mask alone is very helpful. For example, you can known exactly what time the photoresist is fully etched through during an etch (even if by accident), allowing you to stop the etch at that time, and still determine selectivity if desired.

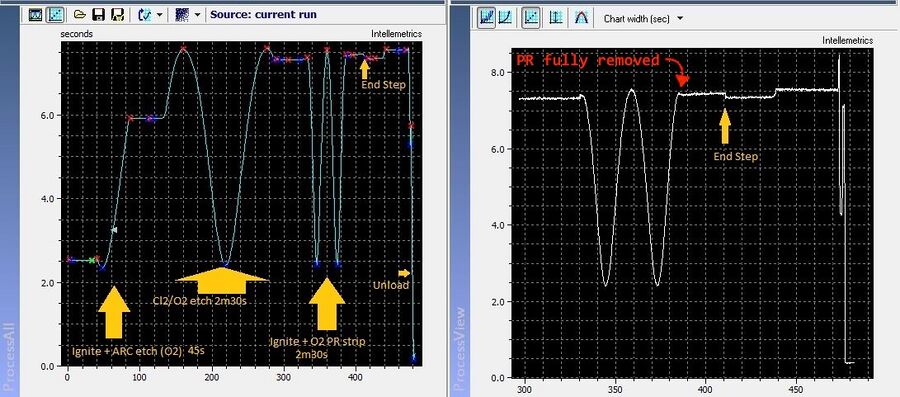
References
See the following pages for more information about laser endpoint detection.
- Intellemetrics LEP
- The Intellemetrics Manuals are available on the tool computers in the lab - you can copy these to your Nanofiles Sync folder to access them remotely.
- Simulation of Laser Endpoint Signal in Python